各種プロセスに対応した製品をご用意しています。
先ダイシング(DBG™:Dicing Before Grinding)プロセスとは
回路面をハーフカットした後、バックグラインドによりウェハ極薄化とチップ分割を同時に行うチップ製造プロセスです。当社マルチウェハマウンター「RAD-2510F/12Sa」と(株)ディスコ製グラインダーによるインラインシステムにより、ウェハ破損リスクを低減し、極薄チップを安定生産できます。
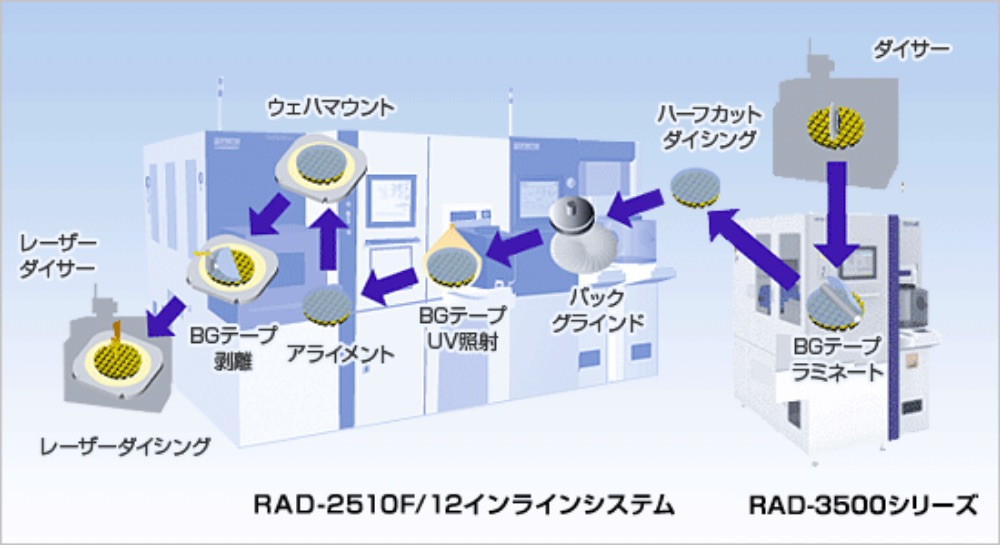
拡大する
先ダイシングプロセス関連製品
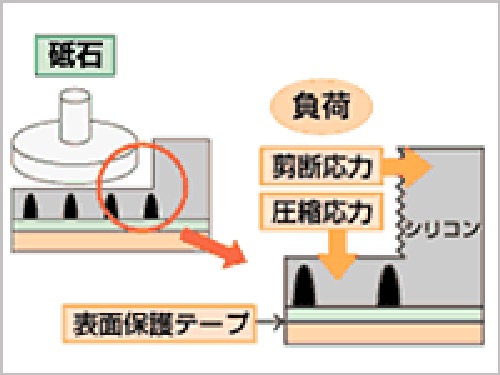 BG用表面保護テープへの研削負荷モデル
BG用表面保護テープへの研削負荷モデル
- ■先ダイシングプロセス対応BG用表面保護テープ
-
研磨中の研削水の浸入を確実に防ぎ、チップ飛散やクラックを発生させないBG用表面保護テープです。BG用テープラミネーター「RAD-3500シリーズ」でラミネートします。
- 1.強い粘着力により研削時のチップ飛散と研削水の浸入を確実に防止
- 2.研削時の圧縮応力と剪断応力を吸収・緩和
- 3.チップ同士の接触によるクラックを抑制
- 4.UV照射で任意に粘着力をコントロール可能
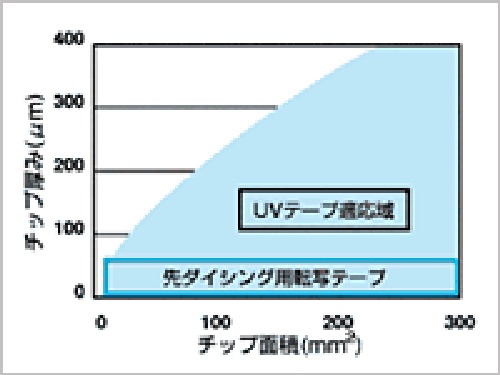 ピックアップテープの適応チップ面積と厚み
ピックアップテープの適応チップ面積と厚み
- ■先ダイシングプロセス用ピックアップテープ
-
バックグラインド後の分割されたチップを表面保護テープからリングフレームに確実に転写する専用のピックアップテープです。マルチウェハマウンター「RAD-2510F/12Sa」でマウントします。
- 1.バックグラインド後の分割されたチップを確実に転写
- 2.ピックアップ時のチップに対するストレスを最小化
- 3.チップ同士の接触によるクラックを抑制
- 4.特殊なUV硬化型テープの採用により、極薄・大型チップの確実なピックアップを実現
- ■先ダイシングプロセス対応ダイシング ダイボンディングテープ
-
先ダイシングプロセスで分割されたチップを貼付し、フルカットレーザーダイシングすることで、粘接着剤層を確実に分割することが可能です。
- 1.低ピックアップのため、極薄チップ製造に有効
- 2.粘接着剤厚みは、7μmをラインアップ

